

发布时间:2025-11-20


前言
作为半导体封装技术的早期代表,轴向封装二极管在推动行业发展中发挥了关键作用。然而,随着电子设备对小型化、电气性能及自动化装配要求的不断提高,轴向封装因其固有结构限制,逐渐难以适应现代半导体产业的需求。与此同时,表面贴装技术(SMT)的兴起,为功率二极管封装开辟了全新的发展路径。
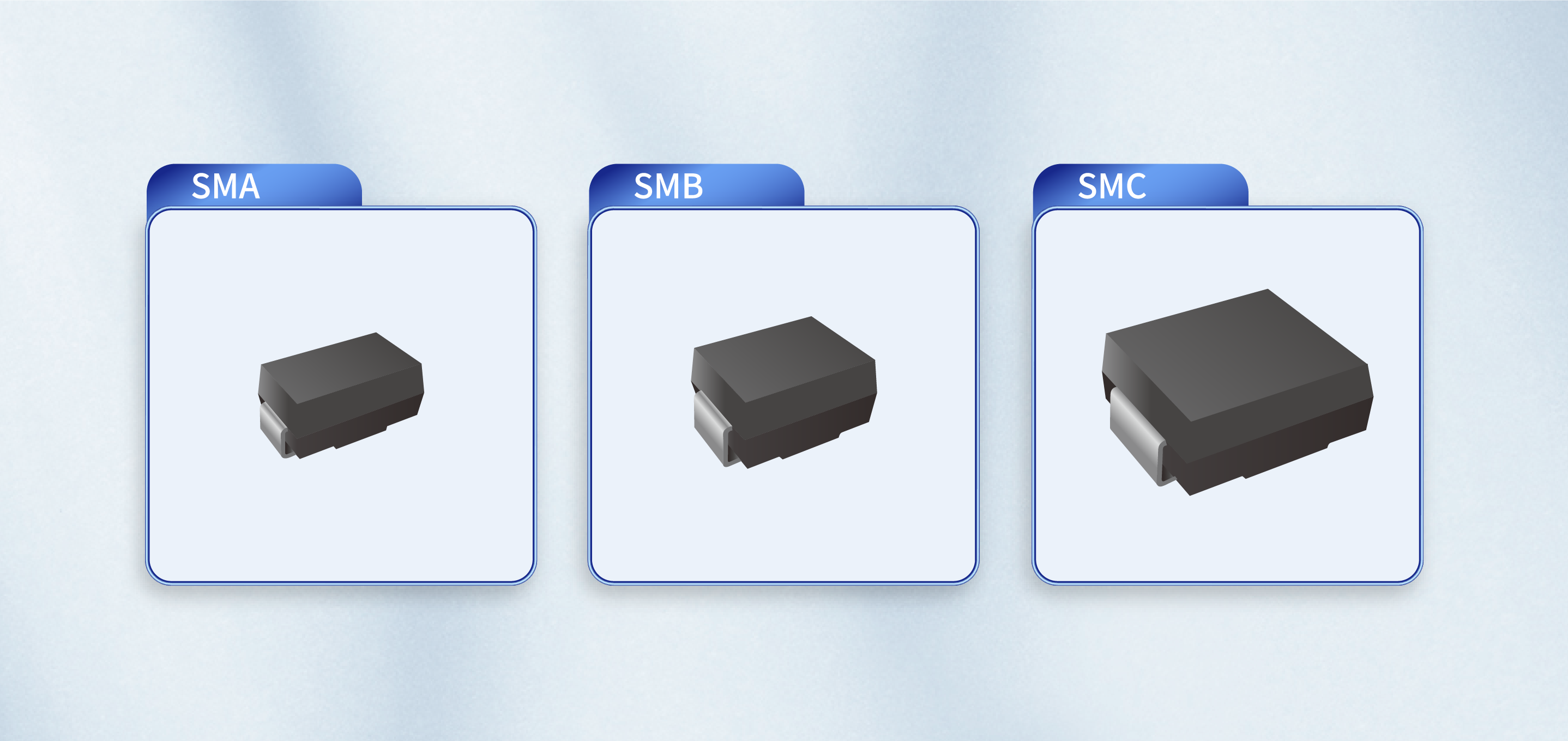
二十世纪七八十年代,消费电子产品——如便携式收音机、录像机以及早期移动电话——的普及,推动了对电子元器件小型化、轻量化与高可靠性的需求。在此背景下,表面贴装技术应运而生,并逐步成为电子制造的主流工艺。
这一阶段,以 SMA、SMB、SMC 为代表的标准化表面贴装封装迅速崛起。该类封装的技术雏形可追溯至1960年代美国 IBM 公司对 SMT 的早期探索,而其产业化与标准化则得益于日本消费电子企业对微型化的持续推动。最终,美国 JEDEC(固态技术协会)在1980年代将其纳入标准体系,例如 DO-214AC(SMA)、DO-214AA(SMB)和 DO-214AB(SMC),使其成为中低功率整流与开关应用的理想封装形式。
相较于轴向封装,SMA/SMB/SMC 封装在体积、贴装效率、电气性能与整体可靠性方面实现了跨越式进步,至今仍在众多应用领域中占据核心地位。
然而,这类已沿用近六十年的封装形式,因为基于早期的设计理念和生产工艺已日渐落后,也开始面临新的技术瓶颈与发展局限:
功率密度提升受限
芯片制造工艺的持续改良,使得芯片尺寸及厚度不断变小,以及环氧树脂封装材料性能的提升,使得传统 SMA 类封装内部出现结构冗余,限制了器件功率密度的进一步提高。尽管后来行业推出了如 SOD-123FL、SMAF、SMBF 等薄型封装变体,通过降低封装厚度试图缓解该问题,但由于未从根本上改变封装的长宽比例,并未实现功率密度蜕变式的变革,反而因散热面积变小导致散热能力削弱。

散热能力面临瓶颈
随着应用端对电流与电压能力的要求不断提高,散热性能成为制约 SMA 类封装发展的关键因素。其内包式引脚设计导致焊接点与封装本体的热量叠加,易形成局部高温区,影响器件及 PCB 的可靠性。后续出现的鸥翼型外延引脚封装(如 SOD-123、SOD-323)在一定程度上缓解了焊接热堆叠问题,但受制与本体尺寸,并不适合较大功率器件的封装。并且在涉及关键的材料热导与整体热设计中未实现根本性突破。
机械应力引发的潜在可靠性问题
SMA 类封装的内包引脚结构,在成型过程中会对引线框架施加更为明显外向拉力,可能造成晶圆焊接界面损伤,引发虚焊、微裂纹甚至封装体开裂等隐匿性缺陷,影响长期可靠性。
成本优化伴随性能妥协
在数十年的发展中,SMA 封装性能已趋于极限。面对市场对低成本与高性能的双重压力,部分制造商被迫采取降低黑胶规格、减薄铜框架等方式控制成本,但这些措施往往以牺牲产品性能与可靠性为代价,只能称为性能妥协的降本方案,伴随巨大的品质风险。
结语

自主研发第二代表面贴装封装产品
可见,经历近半个世纪的发展,SMA 系列封装已从开创时代的经典方案,逐步面临与技术演进及市场需求脱节的挑战。在电子技术高速迭代的今天,一种封装结构沿用六十余年而未发生根本性变革,实属罕见。面对这一局面,行业领先企业如威世(Vishay)等不断推进封装技术创新。领晨科技也始终致力于新型封装结构的研发与改良,其自主研发的第二代表面贴装封装产品,精准针对传统第一代表面贴装封装所面临的痛点,已逐步获得市场认可。下期将整理与深度分析业内针对第一代贴片封装所做的各种变革而推出的封装产品的利与弊。
文章所示内容仅基于领晨科技对封装发展历程的研判,如有不当之处,欢迎指正与交流。
下期预告
微缩的革命:功率二极管封装发展历程(三)
过渡期:稳中求变,封装结构的多元化探索

谢谢阅读
